Home > Press > Exposing the Sensitivity of Extreme Ultraviolet Photoresists
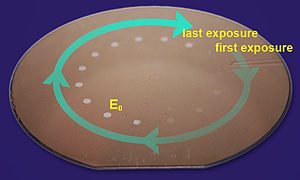 |
| NIST researchers exposed a 300 mm silicon wafer with incrementally increasing doses of extreme ultraviolet light (EUV) in 15 areas. After the wafer was developed, the team determined that the seventh exposure was the minimum dose required (E0) to fully remove the resist.
Credit: NIST |
Abstract:
Researchers at the National Institute of Standards and Technology (NIST) have confirmed that the photoresists used in next-generation semiconductor manufacturing processes now under development are twice as sensitive as previously believed. This finding, announced at a workshop last month,* has attracted considerable interest because of its implications for future manufacturing. If the photoresists are twice as sensitive as previously thought, then they are close to having the sensitivity required for high volume manufacturing, but the flip side is that the extreme ultraviolet optical systems in the demonstration tools currently being used are only about half as effective as believed.
Exposing the Sensitivity of Extreme Ultraviolet Photoresists
GAITHERSBURG, MD | Posted on June 26th, 2008Extreme ultraviolet lithography (EUVL) is a process analogous to film photography. A silicon wafer is coated with photoresist and exposed to EUV light that reflects off a patterned "photomask." Where the light strikes the resist it changes the solubility of the coating. When developed, the soluble portions wash away leaving the same pattern exposed on the silicon surface for the processing steps that ultimately create microcircuits.
The drive to make circuits with ever smaller features has pushed manufacturers to use shorter and shorter wavelengths of light. EUVL is the next step in this progression and requires developing both suitable light sources and photoresists that can retain the fine details of the circuit, balancing sensitivity, line edge roughness and spatial resolution. NIST researcher Steve Grantham says that optical lithography light sources in use today emit light with a wavelength of about 193 nanometers, which borders on optical wavelengths. EUVL sources produce light with wavelengths about an order of magnitude smaller, around 13.5 nanometers. Because this light does not travel through anything�including lenses�mirrors have to be used to focus it.
Until recently, EUV photoresist sensitivity was referenced to a measurement technique developed at Sandia National Labs in the 1990s. Late in 2007, scientists at the Advanced Light Source at Lawrence Berkeley National Laboratory in Berkeley, Calif., used a NIST-calibrated photodetector to check the standard. Their detector-based measurements indicated that the resist's sensitivity was about twice that of the resist-based calibration standard.
Following on the intense interest that these results generated when the Berkeley group presented them at a conference in February, the Intel Corporation asked scientists at NIST to make their own independent determination of the EUVL resist sensitivity to validate the results. Measurements conducted at the NIST SURF III Synchrotron Ultraviolet Radiation Facility agreed with those of the Berkeley group. The fact that the photoresist is now known to be twice as sensitive to the EUV light implies that half as much light energy as had been expected is arriving at the wafer.
"These results are significant for a technology that faces many challenges before it is slated to become a high-volume manufacturing process in 2012," Grantham says. "It should open the eyes of the industry to the need for accurate dose metrology and the use of traceable standards in their evaluations of source and lithography tool performance."
* S. Grantham, C. Tarrio, R. E. Vest, T. B. Lucatorto, A. Novembre, M. Cangemi, V. Prabhu, K.W. Choi, M. Chandhok, T. Younkin and J. S. Clarke. SEMATECH EUV Source Workshop, Bolton Landing, N.Y., May 12, 2008.
####
About NIST
Founded in 1901, NIST is a non-regulatory federal agency within the U.S. Department of Commerce. NIST's mission is to promote U.S. innovation and industrial competitiveness by advancing measurement science, standards, and technology in ways that enhance economic security and improve our quality of life.
For more information, please click here
Contacts:
Mark Esser
(301) 975-8735
Copyright © NIST
If you have a comment, please Contact us.Issuers of news releases, not 7th Wave, Inc. or Nanotechnology Now, are solely responsible for the accuracy of the content.
| Related News Press |
News and information
![]() Quantum computer improves AI predictions April 17th, 2026
Quantum computer improves AI predictions April 17th, 2026
![]() Flexible sensor gains sensitivity under pressure April 17th, 2026
Flexible sensor gains sensitivity under pressure April 17th, 2026
![]() A reusable chip for particulate matter sensing April 17th, 2026
A reusable chip for particulate matter sensing April 17th, 2026
![]() Detecting vibrational quantum beating in the predissociation dynamics of SF6 using time-resolved photoelectron spectroscopy April 17th, 2026
Detecting vibrational quantum beating in the predissociation dynamics of SF6 using time-resolved photoelectron spectroscopy April 17th, 2026
Chip Technology
![]() A reusable chip for particulate matter sensing April 17th, 2026
A reusable chip for particulate matter sensing April 17th, 2026
![]() Metasurfaces smooth light to boost magnetic sensing precision January 30th, 2026
Metasurfaces smooth light to boost magnetic sensing precision January 30th, 2026
Nanoelectronics
![]() Lab to industry: InSe wafer-scale breakthrough for future electronics August 8th, 2025
Lab to industry: InSe wafer-scale breakthrough for future electronics August 8th, 2025
![]() Interdisciplinary: Rice team tackles the future of semiconductors Multiferroics could be the key to ultralow-energy computing October 6th, 2023
Interdisciplinary: Rice team tackles the future of semiconductors Multiferroics could be the key to ultralow-energy computing October 6th, 2023
![]() Key element for a scalable quantum computer: Physicists from Forschungszentrum J�lich and RWTH Aachen University demonstrate electron transport on a quantum chip September 23rd, 2022
Key element for a scalable quantum computer: Physicists from Forschungszentrum J�lich and RWTH Aachen University demonstrate electron transport on a quantum chip September 23rd, 2022
![]() Reduced power consumption in semiconductor devices September 23rd, 2022
Reduced power consumption in semiconductor devices September 23rd, 2022
Discoveries
![]() Quantum computer improves AI predictions April 17th, 2026
Quantum computer improves AI predictions April 17th, 2026
![]() Flexible sensor gains sensitivity under pressure April 17th, 2026
Flexible sensor gains sensitivity under pressure April 17th, 2026
![]() A reusable chip for particulate matter sensing April 17th, 2026
A reusable chip for particulate matter sensing April 17th, 2026
![]() Detecting vibrational quantum beating in the predissociation dynamics of SF6 using time-resolved photoelectron spectroscopy April 17th, 2026
Detecting vibrational quantum beating in the predissociation dynamics of SF6 using time-resolved photoelectron spectroscopy April 17th, 2026
Announcements
![]() A fundamentally new therapeutic approach to cystic fibrosis: Nanobody repairs cellular defect April 17th, 2026
A fundamentally new therapeutic approach to cystic fibrosis: Nanobody repairs cellular defect April 17th, 2026
![]() UC Irvine physicists discover method to reverse �quantum scrambling� : The work addresses the problem of information loss in quantum computing system April 17th, 2026
UC Irvine physicists discover method to reverse �quantum scrambling� : The work addresses the problem of information loss in quantum computing system April 17th, 2026
Photonics/Optics/Lasers
![]() Metasurfaces smooth light to boost magnetic sensing precision January 30th, 2026
Metasurfaces smooth light to boost magnetic sensing precision January 30th, 2026
![]() From sensors to smart systems: the rise of AI-driven photonic noses January 30th, 2026
From sensors to smart systems: the rise of AI-driven photonic noses January 30th, 2026
|
|
||
|
|
||
| The latest news from around the world, FREE | ||
|
|
||
|
|
||
| Premium Products | ||
|
|
||
|
Only the news you want to read!
Learn More |
||
|
|
||
|
Full-service, expert consulting
Learn More |
||
|
|
||








